类别:其他 出处:网络整理 发布于:2023-04-28 17:05:01 | 97 次阅读
追求高效率的高功率应用持续向更高功率密度及成本化发展,也为电动汽车等产业创造了永续价值。为了应对相应的挑战,英飞凌科技股份公司(FSE代码:IFX / OTCQX代码: IFNNY)宣布其高压MOSFET 适用的 QDPAK 和 DDPAK 顶部冷却 (TSC) 封装已成功注册为 JEDEC 标准。这项举措不仅进一步巩固了英飞凌将此标准封装设计和外型的TSC 封装推广至广泛新型设计的目标,也给OEM 厂商提供了更多的弹性与优势,帮助他们在市场中创造差异化的产品,并将功率密度提升至更高水准,以支持各种应用。
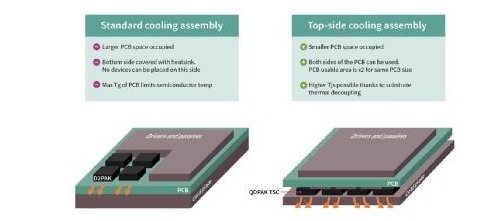
半个多世纪以来,JEDEC组织持续领导全球微电子产业进行各项技术,包括封装外型的开放式标准的开发以及出版物编写工作。JEDEC广泛纳入了各种半导体封装,例如 TO220 和 TO247 通孔器件 (THD)——这类器件在过去几十年来受到广泛采用,目前仍是新型车载充电器 (OBC) 设计、高压 (HV) 和低压 (LV) DC-DC 转换器的设计选项。

凡本网注明“出处:维库电子市场网”的所有作品,版权均属于维库电子市场网,转载请必须注明维库电子市场网,https://www.dzsc.com,违反者本网将追究相关法律责任。
本网转载并注明自其它出处的作品,目的在于传递更多信息,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品出处,并自负版权等法律责任。
如涉及作品内容、版权等问题,请在作品发表之日起一周内与本网联系,否则视为放弃相关权利。